|
查看:
1768
|
回复:
0
|
浅谈FCCSP倒装芯片封装工艺
|


福英达人
6
主题
0
回复 |
1#
电梯直达

随着移动、网络和消费类电子设备更新换代,电子产品的功能越来越多、体积越来越小,对于半导体封装的性能要求不断提高。如何在更薄、更小的外形尺寸下实现更高更快的数据传输成为了一个关键挑战。由于移动设备需要不断增加封装中的输入/输出(I/O)数量,封装解决方案正从传统的线键封装向倒装芯片互连迁移,以满足这些要求。对于具有多种功能和异构移动应用的复杂和高度集成的系统而言,倒装芯片封装(FCCSP)被认为一种有效的解决方案。如图 1 所示,半导体封装互连技术包括引线键合技术和倒装芯片键合技术。 图1. (a)引线键合封装(WBCSP)、(b)倒装芯片封装(FCCSP)的结构示意图 FCCSP封装是一种先进的封装技术,它使用倒装芯片(Flip Chip)作为互连方式,将芯片直接连接到层压板或模塑基板上,通过焊点实现基板电极的互连。倒装芯片键合技术由于可以利用芯片的前表面,因此可以比导线键合技术连接更多的 I/O,而且由于芯片长度比导线长度短约 10 倍,因此具有快速信号处理的优势。因此,倒装芯片键合技术正以各种方式应用于需要快速信号处理的高密度封装或数字封装的互连。 FCCSP封装具有以下特点和优势: 1. FCCSP封装可以提供更高的布线密度,更低的电感,更短的信号通路,从而优化了电气性能,适用于低频和高频应用。 2. 更小的封装尺寸,更薄的封装厚度,更轻的封装重量,满足轻薄、小型、高密度的产品需求。 3. 采用不同的凸块选项,如铜柱、无铅焊料、共晶等,以适应不同的芯片和基板材料,提高了可靠性和兼容性。 4. 支持多晶片(并排堆叠)的应用,实现了更高的集成度和功能性。 5. 支持封装内天线(AiP)的应用,利用底部芯片贴装(POSSUM™)技术,实现了更高的信号质量和效率。 FCCSP封装应用 FCCSP封装已经广泛应用于移动设备(如智能手机、平板电脑等)、汽车电子(如信息娱乐、ADAS等)、消费电子(如数码相机、游戏机等)、通信设备(如基带、RF等)、人工智能(如AI芯片、神经网络等)等领域,是一种具有高性能、高可靠性、高灵活性的封装解决方案。 福英达超微锡膏 Fitech福英达公司是目前全球唯一能制造全尺寸T2-T10超细合金焊锡粉的电子级封装材料制造商,所生产的锡粉和锡膏产品具有良好的粘度稳定性,形状保持和稳定性以及优良的脱模转印性能,长时间印刷后无锡珠、桥连缺陷,适用于FCCSP、WBCSP及SiP等封装工艺。欢迎来电咨询。 返回搜狐,查看更多 |
|




 发表于2024-03-04 11:20:00
发表于2024-03-04 11:20:00
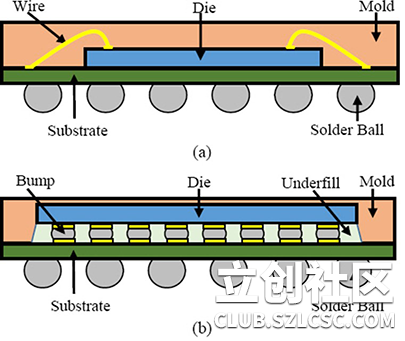


 收藏
收藏
